-
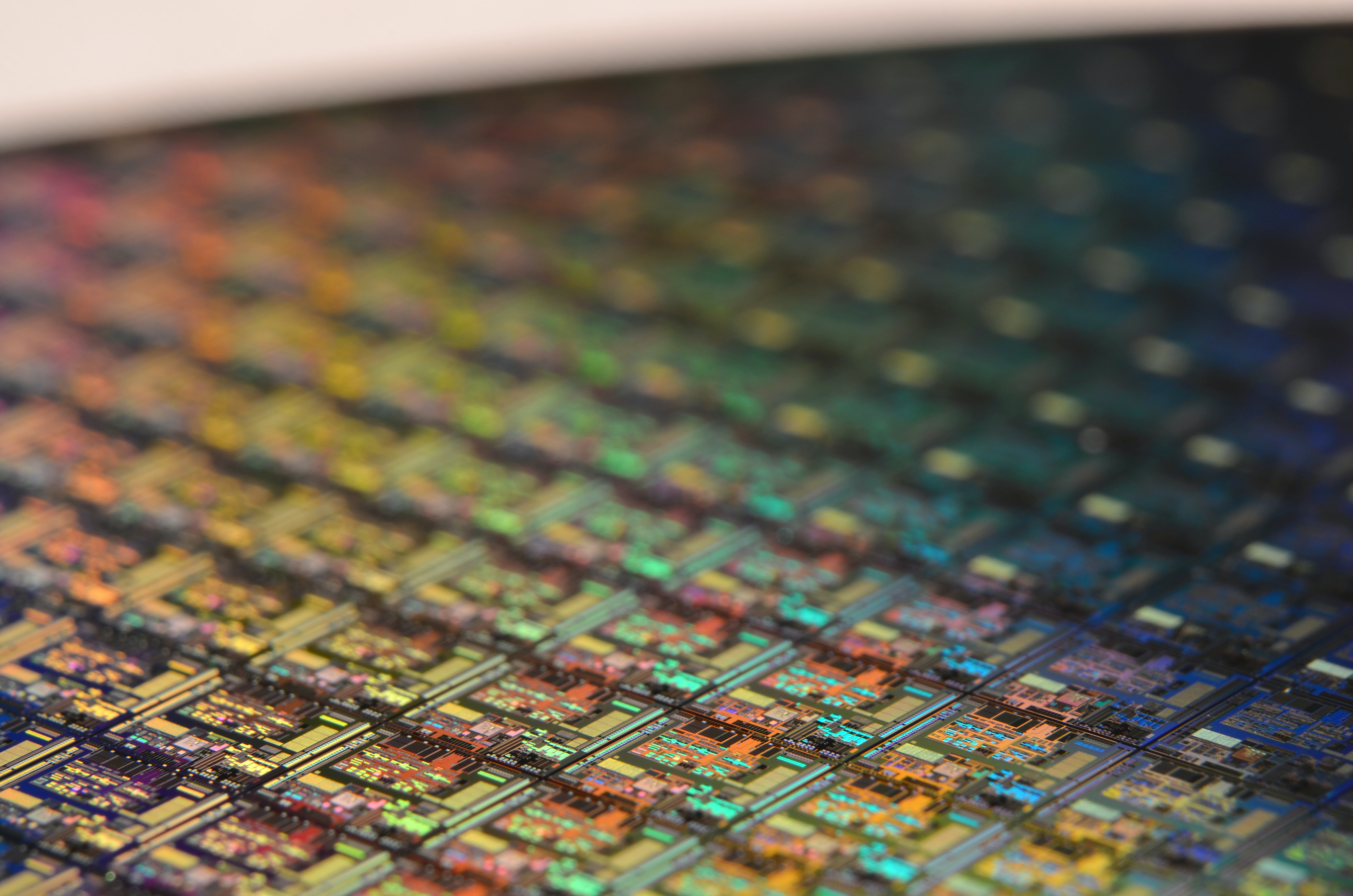
华体会hth体育最新登录-在全球经济动荡中,DELO 仍蓬勃发展
2025年5月12日 | DELO,作为全球领先的高科技粘合剂以及点胶和固化设备制造商之一,尽管面临动荡不安的世界经济形势,仍在2024/2025财年(截至2025年3月31日)实现了超记录的2.45亿欧元的营收,与上一财年相比增长了7%。关键增长巴西和印度是增长最快的市场之一。亚洲仍然是公司最大的
2025-10-17 -
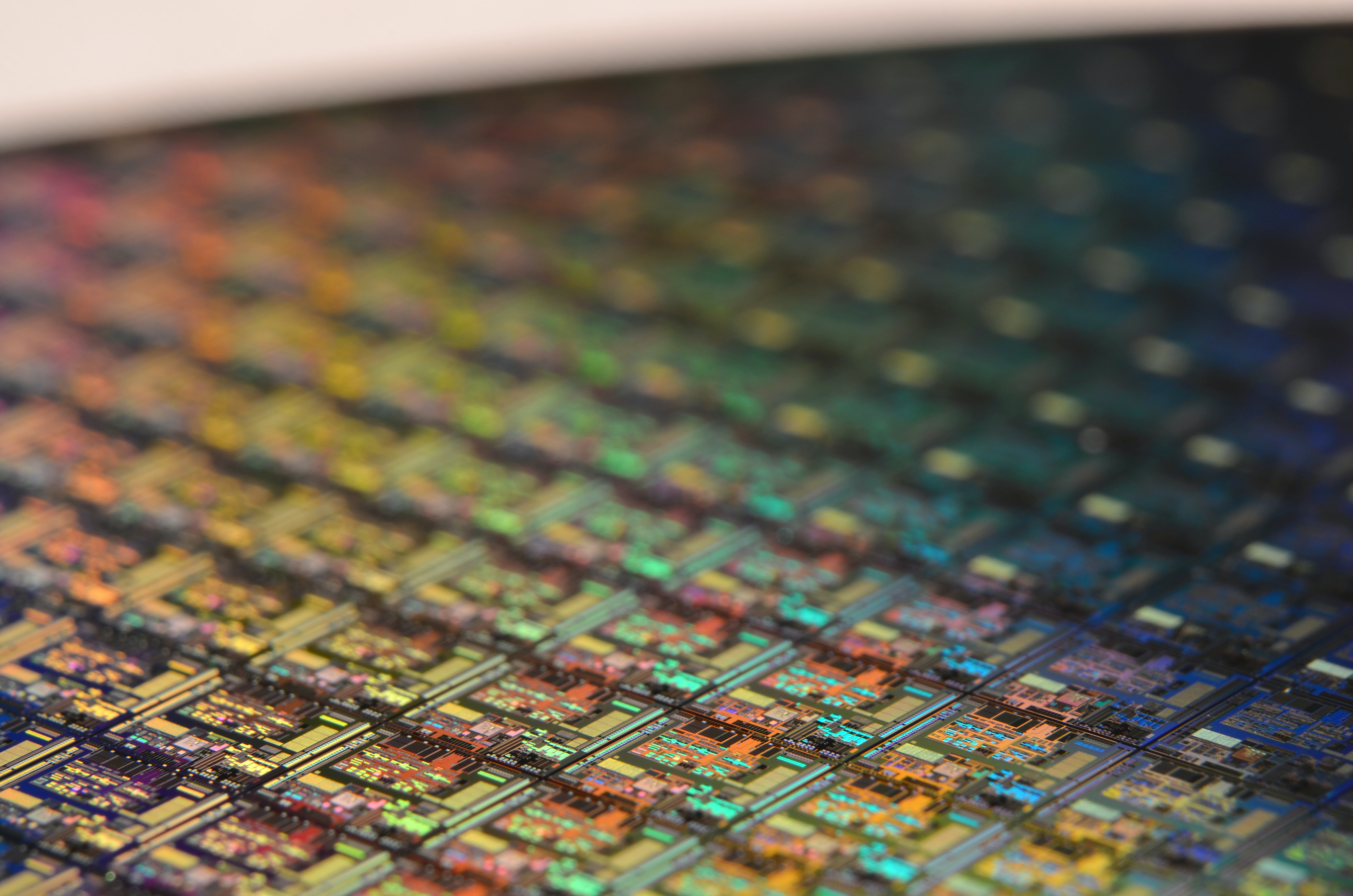
华体会hth体育最新登录-智聚边缘 创见未来 贸泽电子2025技术创新论坛探讨“边缘AI与机器学习”新纪元
提供超丰富半导体和电子元器件™的业界知名新品引入 (NPI) 代理商贸泽电子(Mouser Electronics)宣布将于5月28-20日举办2025贸泽电子技术创新论坛首场活动。本期论坛将深度聚焦“边缘AI与机器学习”,云集Analog Devices, Amphenol, NXP, Silic
2025-10-16 -
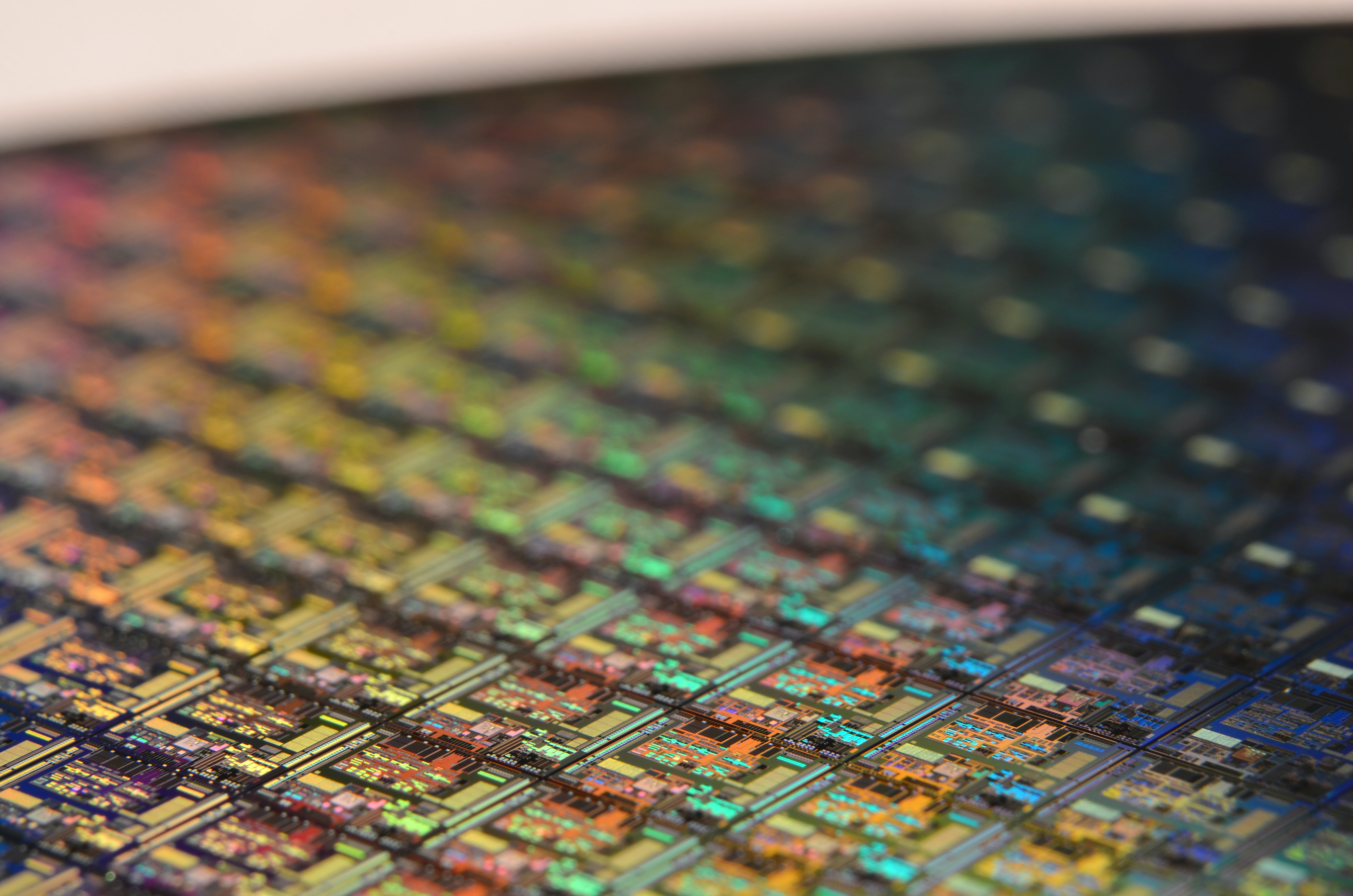
华体会hth体育最新登录-总投资50亿元,先导科技集成电路核心零部件及系统总部基地项目落地临港
据上海临港官微消息,日前,临港新片区管委会、临港集团、先导科技集团在广州共同签署项目投资协议,先导科技集成电路核心零部件及系统总部基地项目正式落地临港新片区。据悉,此次项目投资50亿元,用地108亩,在临港新片区建设集成电路核心零部件基地,包括质量流量控制器、半导体核心金属、真空系统、光刻系统及微纳
2025-10-16 -
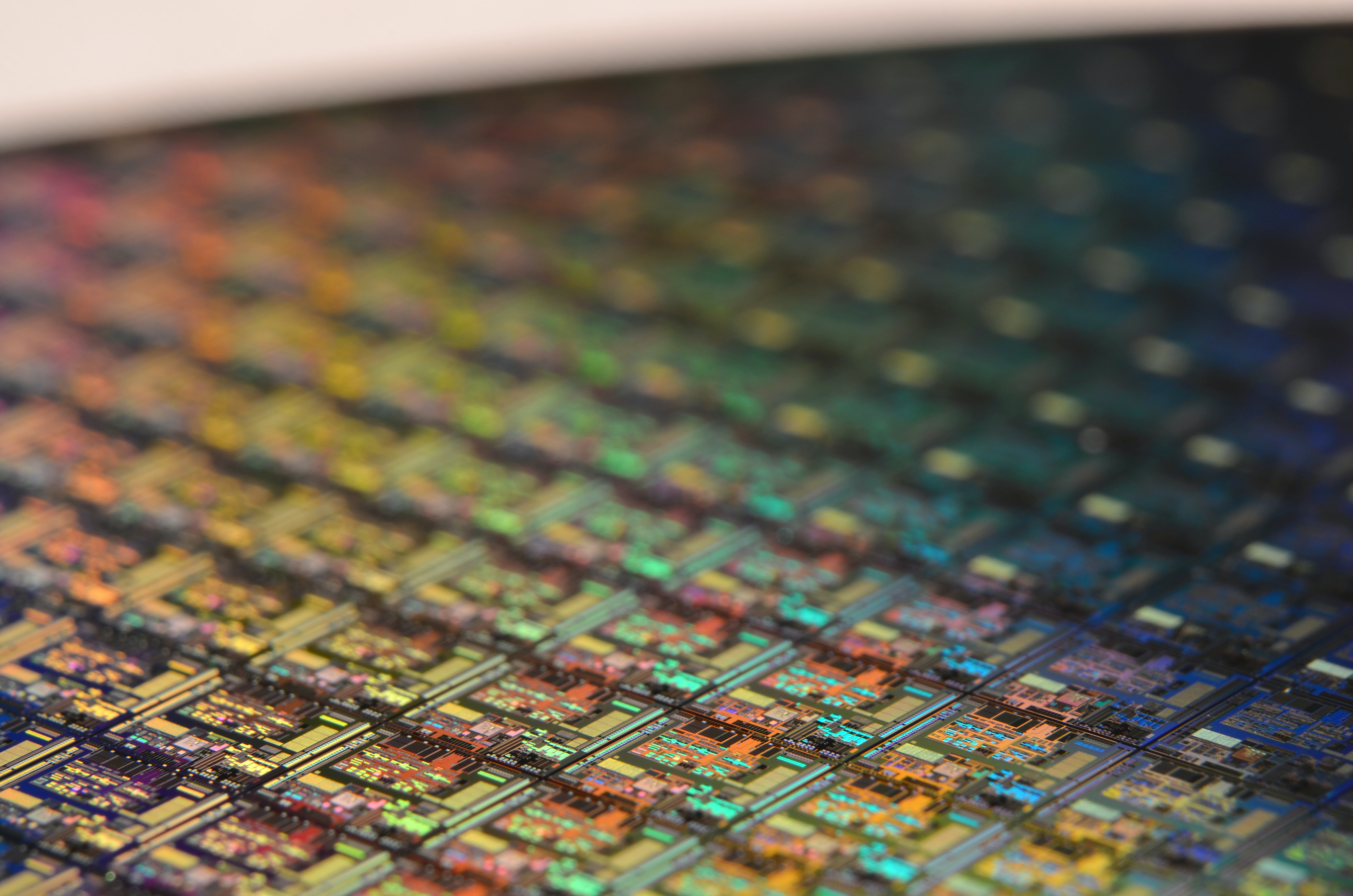
华体会hth体育最新登录-三星电子拟扩建1c DRAM产能
据韩媒报道,三星计划在韩国华城和平泽扩大1c DRAM产能,相关投资将在年底前启动。报道称,三星还考虑在2025年底前将华城17号生产线1z DRAM (第三代10奈米等级)制程技术转为1c DRAM制程技术生产,以进一步扩大产能。三星今年早些时候已在平泽第四园区(P4)启动首条1c DRAM生产线
2025-10-16 -
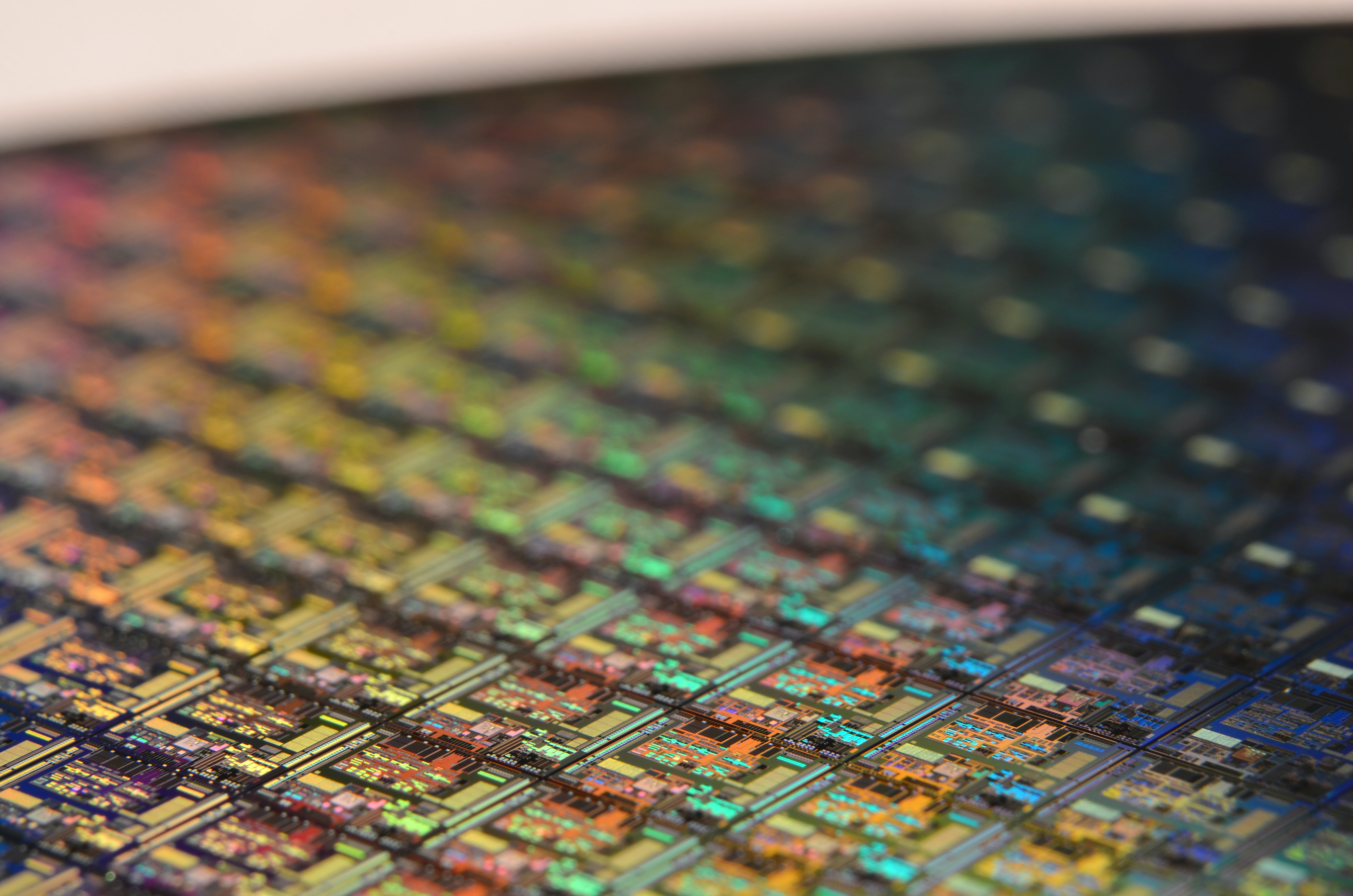
华体会hth体育最新登录-商务部新闻发言人就美国企图全球禁用中国先进计算芯片发表谈话
中方注意到,美国商务部近日发布指南,以所谓推定违反美出口管制为由,企图在全球禁用中国先进计算芯片,包括特定的华为昇腾芯片。美方措施是典型的单边霸凌和保护主义做法,严重损害全球半导体产业链供应链稳定,剥夺其他国家发展先进计算芯片和人工智能等高科技产业的权利。 中方认为,美方滥用出口管制,对中国进行遏
2025-10-16








